1987年,日立公司展示了一种新方法,通过在芯片与基底之间填充具有良好附着力的可固化树脂,有效地重新分配了热应力。1996 年,WONG 等首先提出了无流动填充技术,大大提高了底部填充工艺的生产效率。在随后的几年里,模压填充、晶圆级填充和其他底部填充工艺也被开发出来,以满足倒装芯片封装日益增长的功能要求。试验证明,底部填充胶可以降低关键焊点 10%~25% 的应力缓冲能力,极大地提高了器件的可靠性。此外,底部填充胶可以保护芯片和焊点免受氧气和水分的腐蚀,以及机械应变,如冲击、跌落和振动,进一步提高电子元器件的可靠性。根据倒装封装填充工艺,目前的填充工艺主要分为毛细管底部填充、无流动底部填充和模压底部填充工艺。由于毛细管底部填充工艺简单、形成不完全填充和空隙缺陷的概率较低,兼容性更好,在实际应用中得到广泛应用,并覆盖了超过 60%的底部填充市场。毛细管底部填充工艺是在基板上加入助熔剂,将芯片有源面倒置在基板上,通过回流焊将芯片与基板相连,清理剩余助熔剂。组装后,底部填充胶利用毛细现象施胶填入芯片与基板的空隙中。最后通过加热固化,完成封装,具体过程如图1所示。
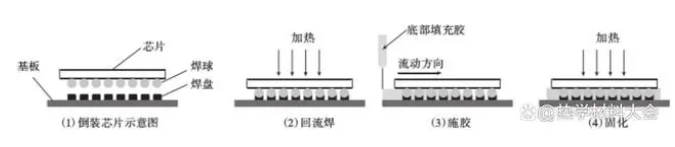
01底填充胶材料的性能需求
一般而言,底部填充胶应具有低黏度,以便其能够容易地流动并完全填充芯片和基板之间的间隙。与焊点之间的CET 较小,以及较高的玻璃化转变温度(Tg),以确保电子设备即使在较高工作温度下的可靠性。底部填充胶的弹性模量和断裂性能也与器件的完整性和可靠性有关。此外,底部填充胶应采用电绝缘材料(避免短路)、介电常数低(保证信号传播速度高)、介电损耗系数低(减少信号损耗)。半导体集成电路技术在过去的 50 年里发展迅速,晶体管栅极长度已经从 10 μm 减少到 4 nm,并且芯片堆叠技术已经实现了从 2D、2.5D 演变到 3D,并伴随着局部功率密度达到100 W/cm2以上。集成电路芯片在积累热量时产生的过量热量会导致温度的急剧上升,从而呈指数级降低电子设备的寿命。因此,高效的散热也是保证其可靠性和性能的关键。用于电子封装的理想高性能底部填充材料应同时具有高导热系数(>1.0 W·m–1·K–1)、高电阻率(>1012 Ω·cm)、低黏度(298 K 时<20 Pa·s)、适当的 CTE(25~30 ppm/K)、高 Tg(>398 K)、低介电常数(298 K 和 1 kHz 时 <4.0)和低的介电损耗因子(298 K和1 kHz时<0.005),如表1所示。

然而,传统的环氧基底填充材料的导热系数通常低于 0.4 W/(m·K),这很难满足不断增加的散热要求。SEO 等通过试验证明,随着底填充材料的导热系数从 0.4 W/(m·K)增加至 1.0 W/(m·K),封装的热阻降低了 22%,导致更好的散热。因此,底填充材料的导热系数对于功率密度不断增加的微电子技术非常重要。通常,为提高导热性能,通过在环氧树脂中加入大量的导热无机填料,可以提高底填材料的导热性。但无机填料的存在增加了底部填充胶的黏度,填充时间更长,难以消除流动过程中内部的空隙,导致应力集中而失效。因此,制造具有组合热-电-机械性能,特别是高导热系数和低黏度的底填材料是迫切的需要和挑战。
02导热性能
环氧树脂具有良好的力学性能、高耐热性和易加工性,因此被广泛用于倒装芯片底部填充材料。但固化的环氧基团内部无序的非晶态链结构导致严重的声子散射和低的传热效率,因此传统的环氧树脂导热系数一般在 0.2 W/(m·K)以下,限制了其作为底部填充材料的散热能力。将高导热性填料加入到环氧树脂中已被证明是一种简便、有效的方法,可以提高导热性,同时保持良好的加工性/流动性。这是制造倒装芯片底部填充材料最常用且最有前景的一种策略。
2.1 填料提升导热性能
WEI 等采用溶胶-凝胶法合成了富含 SiO2涂层的多壁碳纳米管(MWCNT@SiO2),并将其加入环氧基体中,如图2所示。
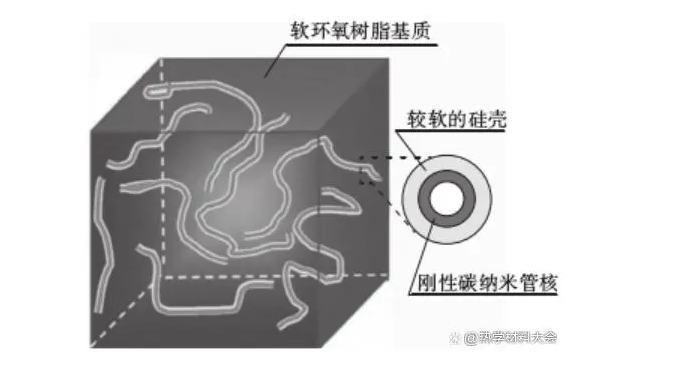
较弱的硅中间壳不仅缓解了多壁碳纳米管与软环氧树脂之间的模量不匹配,而且改善了它们之间的相互作用。环氧树脂/MWCNT@SiO2复合材料的热导率在低负载量为 0.5% 和 1% 时,分别提高了51% 和 67%。同时,硅壳层保持了环氧复合材料的高电阻率,如图3所示。

这种 SiO2涂层策略已广泛应用于高固有导热性填料,可用于实现高导热性和电绝缘的环氧复合材料。HSIAO 等报道了由热还原氧化石墨烯(TRGO)和 SiO2组成的夹层结构的混合纳米片,如图 4所示。
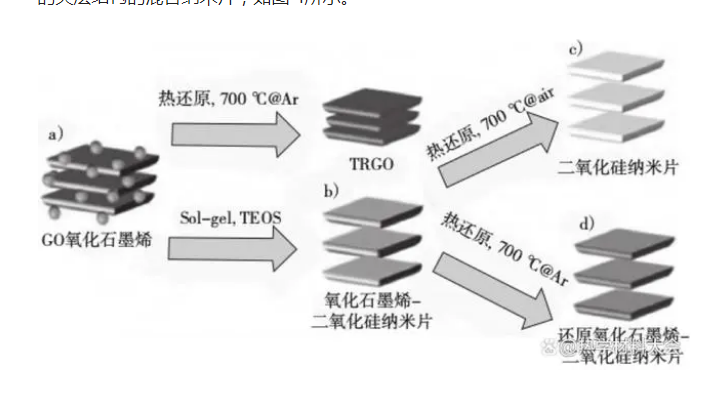
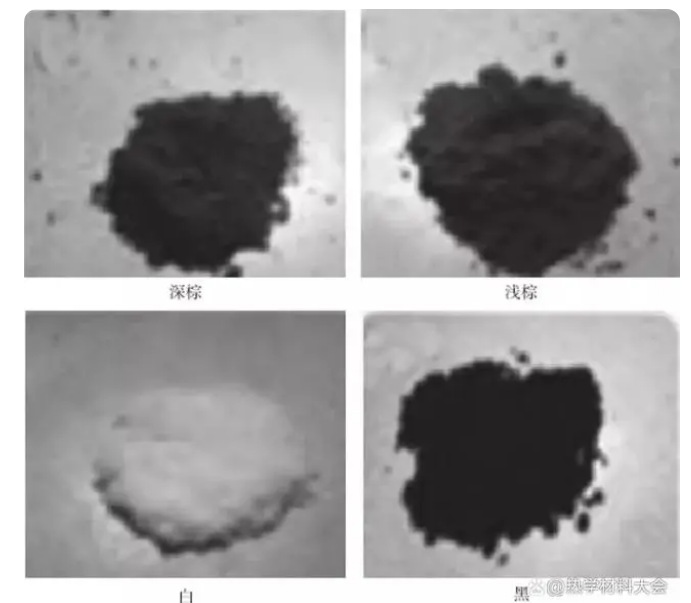
SiO2层覆盖了 TRGO 的表面,阻碍了导电并有效地形成了3D声子传输通道,该通道对环氧树脂基体的电学和热学性能具有独特的影响。单纯的环氧树脂的热导率为 0.2 W/(m·K),而含有 1%TRGO-SiO2环氧纳米复合材料的热导率为 0.322 W/(m·K),提高了61%。JIANG 等通过在不同长度/直径比值的AgNWs 表面包覆二氧化钛(TiO2)涂层(命名为AgNWs@TiO2),并评估了对环氧树脂/银纳米线(epoxy/AgNWs)复合材料的弹性模量失配对热导率的影响,结果如图 5 和图 6 所示。

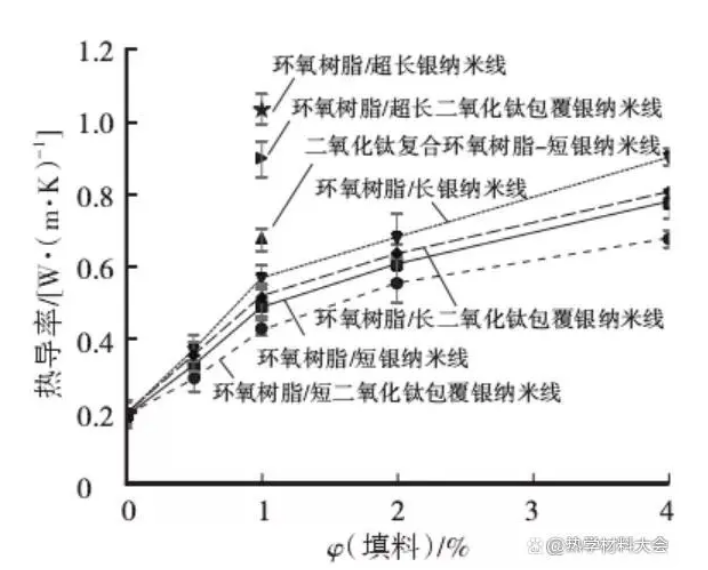
与 epoxy/AgNWs复合材料相比,AgNWs@TiO2可以更均匀地分散在环氧树脂基体中,具有较高弹性模量的 TiO2层增加了与环氧树脂的模量失配,加剧了界面声子散射,在填料体积分数 4.0% 的时,epoxy/AgNWs@TiO2复合材料的热导率为 0.673 W/(m·K)。此外,epoxy/AgNWs@TiO2复合材料相对于环氧树脂/AgNWs 复合材料具有更高的体积电阻率和更低的介电性能。石墨烯由于其优异的宽高比和导热性可以显著提高聚合物的导热性,但石墨烯会导致电绝缘性严重降低,从而限制了其聚合物复合材料在电子和系统热管理中的广泛应用。为了解决这个问题,北京化工大学于中振教授团队使用电绝缘的Al2O3来装饰高质量(无缺陷)石墨烯纳米片(GNP)。在超临界二氧化碳(scCO2)的辅助下,通过高温煅烧制备了 Al2O3@GNP 复合材料,具有 12%Al2O3@GNP 杂化物的环氧树脂复合材料具有 1.49 W/(m·K)的高热导率,比纯环氧树脂高 677%,表明其作为环氧基导热型底部填充胶材料的巨大潜力,如图 7 和图 8所示。


MAO 等报道了由核壳结构 Al@Al2O3和环氧树脂组成的导热绝缘热界面材料。在填料含量为 60%时,复合材料的导热系数为 0.92 W/(m·K),比环氧树脂的导热系数高约 4.2 倍。DU 等通过将氧化镁涂层的石墨烯(MgO@GR)纳米材料掺入环氧树脂基体中,环氧树脂的性能得到改善。添加MgO 涂层不仅改善了石墨烯在基体中的分散性和石墨烯与环氧树脂之间的界面结合,而且提高了环氧树脂的导热性。添加 7% MgO@GR 后,环氧树脂纳米复合材料的热导率比纯环氧树脂提高了76%。除了 SiO2、TiO2、Al2O3以及 MgO 等无机填料以外,其他具有较高导热性能的填料也经常被用于底部填充胶材料,如氮化硼(BN,60 W·m–1·K–1)等。
2.2 界面调节提升导热性能
2.2.1 构建界面模量层
一般而言,填充有纳米结构核壳导热填料的环氧树脂复合材料的热导率高于嵌入未经处理的导电填料的环氧树脂复合材料。绝缘材料中热传导的主要载体是声子,它是由晶格振动(在晶体材料中)或原子振动(在非晶材料中)产生的。在声子传播过程中,任何晶格不连续都会导致声子散射并产生界面电阻。一般来说,高导热材料的高频声子模式在被传输到相邻材料之前,会通过声子-声子耦合转移或分裂成低频声子模式。密度和固有声速(声子频率)差异较大的两种材料将提供更大的声阻抗和界面热阻。因此,两种材料之间的声子频率失配越高,通过界面传输的声子就越少,从而导致传热效率降低。不同材料之间的声子频率失配程度是很难快速估计的。然而,德拜温度(Debye Temperature)是激活最大声子频率并描述原子振动特性的温度。因此,Debye 温度通常用于定性分析不同材料之间的界面热阻(Rk)。此外,Debye 温度与材料中的平均声子速率成正比并反映其弹性刚度,高弹性刚度表明晶格内的原子间相互作用有利于声子传输。因此,具有高弹性模量的材料,如碳纳米管、石墨烯和金刚石,具有高 Debye 温度和高晶格热导率。相比之下,聚合物通常具有较弱的弹性模量,表明平均声子速率较慢且热导率较低。在刚性填料和低刚性聚合物之间加入中间弹性模量层,可以降低界面材料的声子频率差,从而降低界面热阻并提高其复合材料的导热率。CHAO 等通过灵活的溶胶-凝胶法合成了二氧化硅涂层的银纳米线(AgNWs@SiO2),然后掺入环氧树脂中。SiO2的杨氏模量为 70 GPa,环氧树脂基体和 AgNWs 分别为 3 GPa 和 102 GPa。因此,AgNWs 上硬度较低的二氧化硅中间纳米层不仅减轻了 AgNWs和环氧树脂之间的模量不匹配,而且增强了它们的界面相互作用。填充量为 4 vol.%的环氧树脂/AgNWs@SiO2复合材料的热导率从纯环氧树脂的 0.19 W/(m·K)增加到 1.03 W/(m·K),而具有相同纳米线的环氧树脂/AgNWs 复合材料的热导率为0.57 W/(m·K)。因此,二氧化硅纳米层就像一个跳板,可以降低声子传播势垒,降低界面热阻并提高环氧树脂/AgNWs 纳米复合材料的导热性。同时,绝缘 SiO2纳米层有效地避免了在环氧树脂中形成AgNWs 的导电网络,从而使复合材料具有高电绝缘性。具有核壳结构的 AgNWs@SiO2纳米线也改善了环氧树脂的介电性能。因此,这些环氧树脂/AgNWs@SiO2复合材料具有适合电子封装底部填充材料的潜力,如图9和图10所示。

2.2.2 界面填料的表面修饰
不仅可以通过在填料上引入中间模量层来降低环氧树脂基体和填料之间的整体界面热阻,还可以通过在填料表面添加官能团来降低界面热阻。LOSEGO 等在试验中发现,界面相互作用强度直接决定了两种材料界面上的声子热传输过程。随着界面相互作用从范德华力转变为共价键,石英基板和金膜界面之间的界面热导率增加了 80%。WANG 等使用分子动力学模拟,研究了官能团对功能化石墨烯和环氧树脂之间的声子转移影响。与原始石墨烯相比,功能化石墨烯的声子振动功率谱与环氧树脂基质的重叠显著增加,表明功能化石墨烯和环氧树脂之间的声子耦合要好得多。由于官能团增强了石墨烯和环氧树脂之间的相互作用,它们的基体-填料界面热导率增加,从而提高了复合材料的热导率,如图11所示。

通过表面改性降低界面热阻已被广泛用于通过减少界面处的声子散射,来提高填料负载复合材料的导热性。JIANG 等通过自由基聚合接枝聚甲基丙烯酸缩水甘油酯(PGMA)于 BN 表面。用PGMA 对 BN进行表面改性增强了 BN和环氧树脂之间的界面相互作用,从而降低了界面电阻。因此,具有体积分数 15% 的 PGMA 接枝 BN 的环氧复合材料显示出 1.2 W/(m·K)的热导率,比填充原始 BN 的高约15%。
2.3 提高填料的分散性
良好的填料分散有助于通过增强填料与填料的连通性形成导热路径。YAN 等开发了一种简便、省时且可扩展的方法,通过在环氧树脂基体中原位球磨 BN 来制造导热但低黏度的环氧树脂复合材料,如图12所示。

环氧树脂辅助研磨大大改善了 BN 片晶在基体中的分散性,含有 9.1% 球磨 BN 的环氧树脂复合材料显示出 0.44 W/(m·K)的热导率,比没有球磨制备的复合材料热导率提高了37%。
2.4 构建混合填料网络结构
与单一填料相比,混合填料可以通过增加填料填充密度和互连性来建立有效的导热路径,从而进一步提高复合材料的导热性。HAN 等通过超声波浸渍、溶胶-凝胶和碳热还原等方法构建了一种巢状异质结构 BNNS@SiCnws导热填料。然后,采用共混浇注法制备了导热绝缘 BNNS@SiCnws/环氧树脂复合材料。当BNNS@SiCnws-II(质量比为65/35)作为填料的用量为 20% 时,BNNS@SiCnws/环氧树脂复合材料的整体性能最佳。导热系数从纯环氧树脂基体的 0.22 W/(m·K)增加到 1.17 W/(m·K),高于SiCnws/环氧树脂(0.72 W·m–1·K–1)和 BNNS/环氧树脂(0.82 W·m–1·K–1)。同时,BNNS@SiCnws/环氧树脂复合材料表现出优异的传热/散热效率。这是由于SiCnws和BNNS“线对面”异质结构的协同作用,可以显著提高导热路径的形成概率,如图 13 和图 14所示。

2.5 降低接触热阻
通过烧结金属或共价键桥接相邻的填料,形成有效的热传输结来降低接触热阻,从而提高复合材料的热导率。华中科技大学解孝林教授等通过在氮化硼纳米片(BNNS)表面原位烧结银纳米颗粒,在环氧树脂复合材料中形成具有良好填料-填料界面接触的连续导热网络。在这种复合材料中,均匀分散且剥离良好的 BN 纳米片通过位于 BNNS 处的烧结 AgNPs 相互桥接,并形成 3D 氮化硼纳米片网络。热烧结后,环氧树脂/BNNS@AgNPs 复合材料与3D 氮化硼纳米片网络的热导率在 20% 的填充量下从 0.95 W/(m·K)增加到 1.13 W/(m·K)。这表明合并 AgNPs 用作热传输结,可以降低 3D BNNS 网络中的热接触电阻,如图15所示。
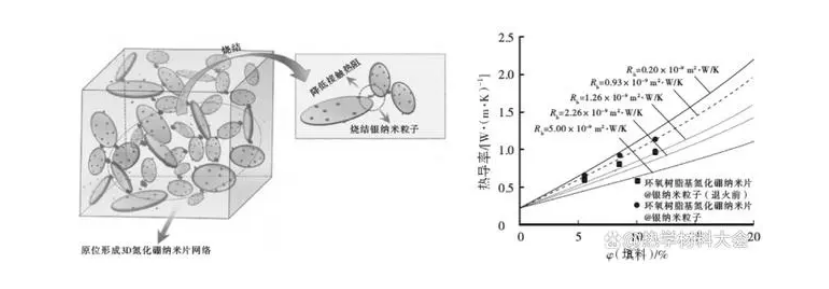
03展望
(1)综述了环氧树脂基复合材料作为导热底部填充胶材料的研究进展,研究表明添加 SiO2、TiO2、Al2O3、MgO、BN、SiC以及Ag等无机填料或CNT、石墨烯等碳材料可以提高环氧基复合材料的导热性能。
(2)通过构建界面模量层、界面填料的表面修饰、提高填料的分散性、构建混合填料网络结构、降低接触热阻等方式,可以大大提高环氧基复合材料的导热性能。(3)具有高固有导热性能的 Ag、SiC、CNT 和石墨烯等填料比目前商业化的 SiO2填料的价格更高,限制了其产业化应用。未来需要通过学术界和工业界的共同努力,以低成本规模化生产更高导热型环氧树脂基底部填充胶材料。
(4)精确设计特定的环氧树脂分子结构(比如具有特定官能团的环氧树脂、修饰烷氧基硅基基团、阻燃基团和环氧玻璃体等大分子)可以提高环氧树脂本征导热性能、降低黏度、增强尺寸稳定性、提高阻燃性等特性,为先进封装,如 2.5D、3D等封装结构设计性能更加优异的底部填充胶材料。




